Röntgenbeugungsmethoden
Röntgenbeugung
Die regelmässige Anordnung von Atomen oder Ionen in einem Kristallgitter führt zur Ausbildung von verschiedenen parallel angeordneten sogenannten Netzebenenscharen. Fällt ein Röntgenstrahlbündel unter einem Winkel theta auf eine solche Netzebenenschar, werden die Teilstrahlen gebeugt und reflektiert. Entspricht die Wegdifferenz der Teilstrahlen einem ganzzahligen Vielfachen der Wellenlänge, so erfolgt konstruktive Interferenz (Bragg-Bedingung).

Phasenanalyse
Trägt man die Intensität der reflektierten Teilstrahlen in Abhängigkeit vom Detektorwinkel 2theta auf, entsteht ein sogenanntes Diffraktogramm, in dem die Reflexlagen durch die Netzebenenabstände bestimmt sind und die Intensitäten sich aus der Elektronendichte auf den Netzebenen ableiten. Ein solches Diffraktogramm ist wie ein "Fingerprint"; und kann durch Vergleich mit einer Datenbank einer Substanz und ihrer Kristallstruktur zugeordnet werden.

Grazing Incidence
Da bei Systemen mit sehr dünnen Oberflächenschichten die Informationstiefe einer solchen theta-2theta-Messung (th2th) um ein Vielfaches grösser ist als die Schichtdicke, stammt ein grosser Teil der erhaltenen Information aus dem Substrat. Verringert man den Einstrahlwinkel theta, verändert sich das Verhältnis von Schicht- zu Substratinformation zugunsten der Schichtinformation. Eine asymmetrische Messung bei sehr kleinem und konstantem Einfallswinkel (Grazing Incidence: GI) liefert deshalb optimale Bedingungen zur Analyse dünner Schichten.

Texturuntersuchungen
Die Vergleichsdaten der Datenbanken beruhen auf einer statistischen Verteilung der Kristallite wie in einem Pulver. Wird durch die Form der Partikel oder durch die Art ihrer Herstellung eine Abweichung von dieser statistischen Verteilung bewirkt, so spricht man von einer Vorzugsorientierung oder Texturierung und die Reflexintensitäten weichen z.T. erheblich von den Vergleichsdaten ab. Texturuntersuchungen werden mit Hilfe von Polfiguren durchgeführt. Bei diesen Messungen wird die Intensität eines ausgewählten Reflexes beim Drehen (Phi) und Kippen (Psi) der Probe aufgezeichnet. Die Halbwertsbreiten der Peaks lassen Schlüsse auf die Grösse der Verkippung (Psi) oder der Rotation (Phi) der Kristallite zu, das Auftreten von Ringen z.B. ist eine Folge der Rotationssymmetrie, die charakteristisch für eine Fasertextur ist.
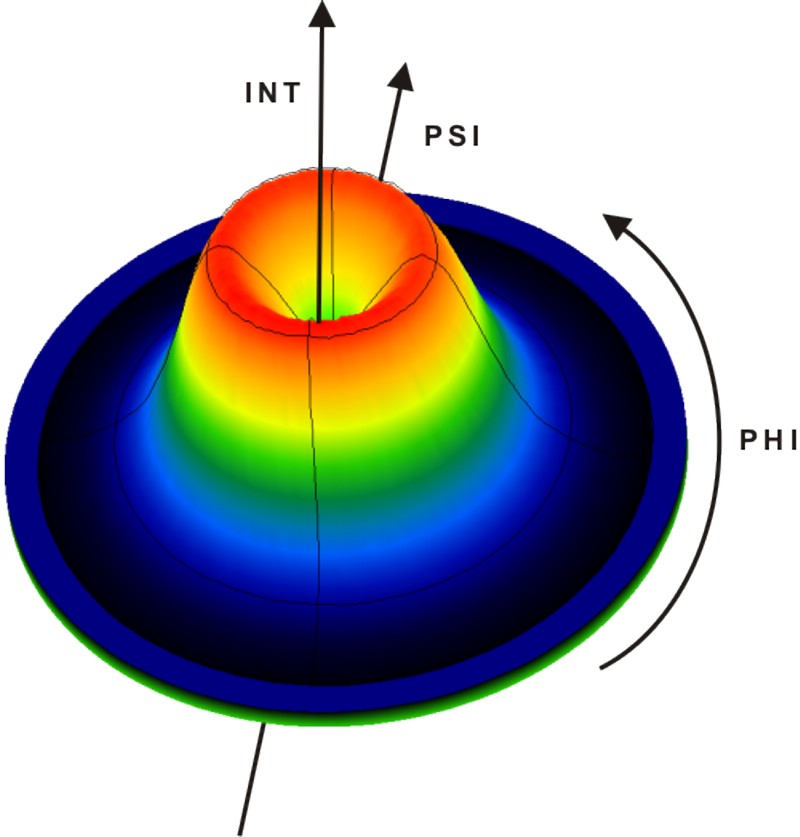
Eigenspannungsmessungen
Das Aufbringen dünner Schichten ist ein sehr komplexer Prozess und die Prozessführung beeinflusst die Qualität der Schichten sehr stark. Die Struktur des Substratmaterials kann eine bestimmte Ausrichtung der Kristalle der Schicht erzwingen. Unterschiede in den thermischen Ausdehnungskoeffizienten der Materialien schaffen zusätzliche Spannungen. Da Schichtspannungen einen grossen Einfluss auf die Schichthaftung haben, ist es wichtig, diese festzustellen und zu kontrollieren. Für eine solche Untersuchung wird die Veränderung der Position eines ausgewählten Reflexes (2theta) beim Kippen der Probe unter verschiedenen Winkeln (psi) gemessen. Die aus den Messwerten resultierende sin2(psi)-Darstellung erlaubt die Bestimmung von Druck-/ Zugspannung oder Scherspannung.
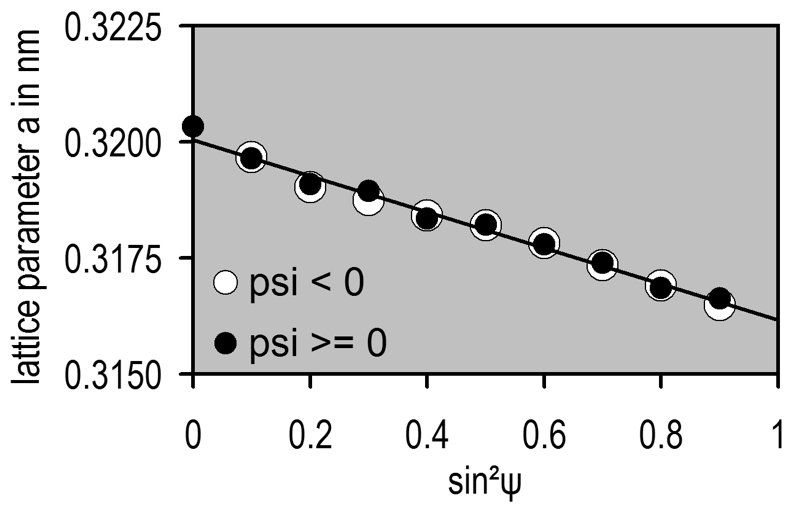
Röntgenreflektometrie
Bei der Herstellung von mikroelektronischen Devices werden dünne Einzelschichten oder Schichtsysteme zur Realisierung der verschiedensten Funktionen auf dem Chip benötigt. Die Schichtdicken dieser Schichten liegen im Bereich von 20 bis 100 nm. Die Bestimmung der Schichtdicke, aber auch der Dichte oder der Rauheit der einzelnen Schichten mit der Röntgenreflektometrie ist eine interessante Analysemethode, vor allem weil durch sie auch die "verborgenen" Schichten betrachtet werden können. Da das Schichtsystem als solches und nicht die kristalline Struktur der Schichten die Grundlage für die Messung bildet, sind auch nichtkristalline Schichtmaterialien wie z.B. SiO2 der Untersuchung zugänglich.


